Breakdown voltage enhancement in GaN channel and AlGaN channel HEMTs using large gate metal height
Logarithmic electron concentration distribution in GaN channel HEMTs with εr = 28, t = 0.5 μm, VDS = 200 V, and (a) h = 0.2 μm or (b) h = 0.4 μm.
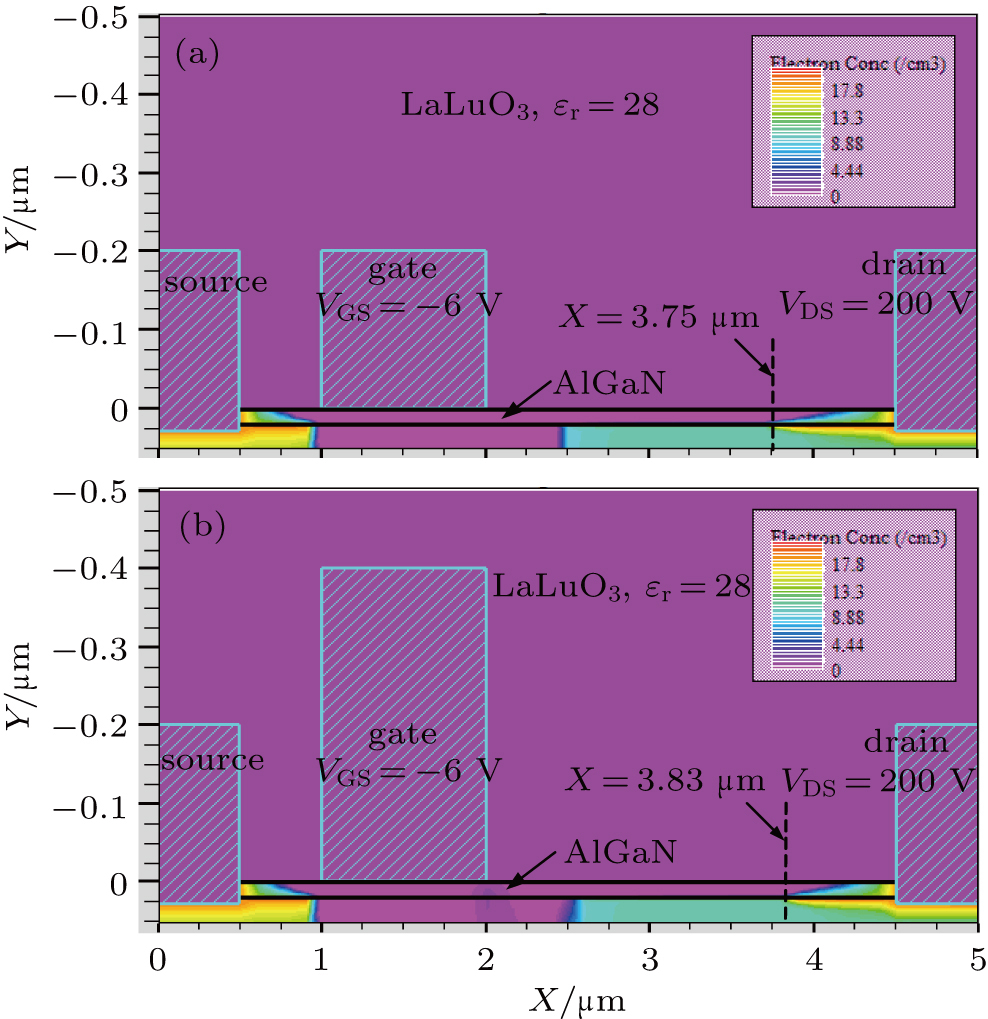
Breakdown voltage enhancement in GaN channel and AlGaN channel HEMTs using large gate metal height |
Logarithmic electron concentration distribution in GaN channel HEMTs with εr = 28, t = 0.5 μm, VDS = 200 V, and (a) h = 0.2 μm or (b) h = 0.4 μm. |
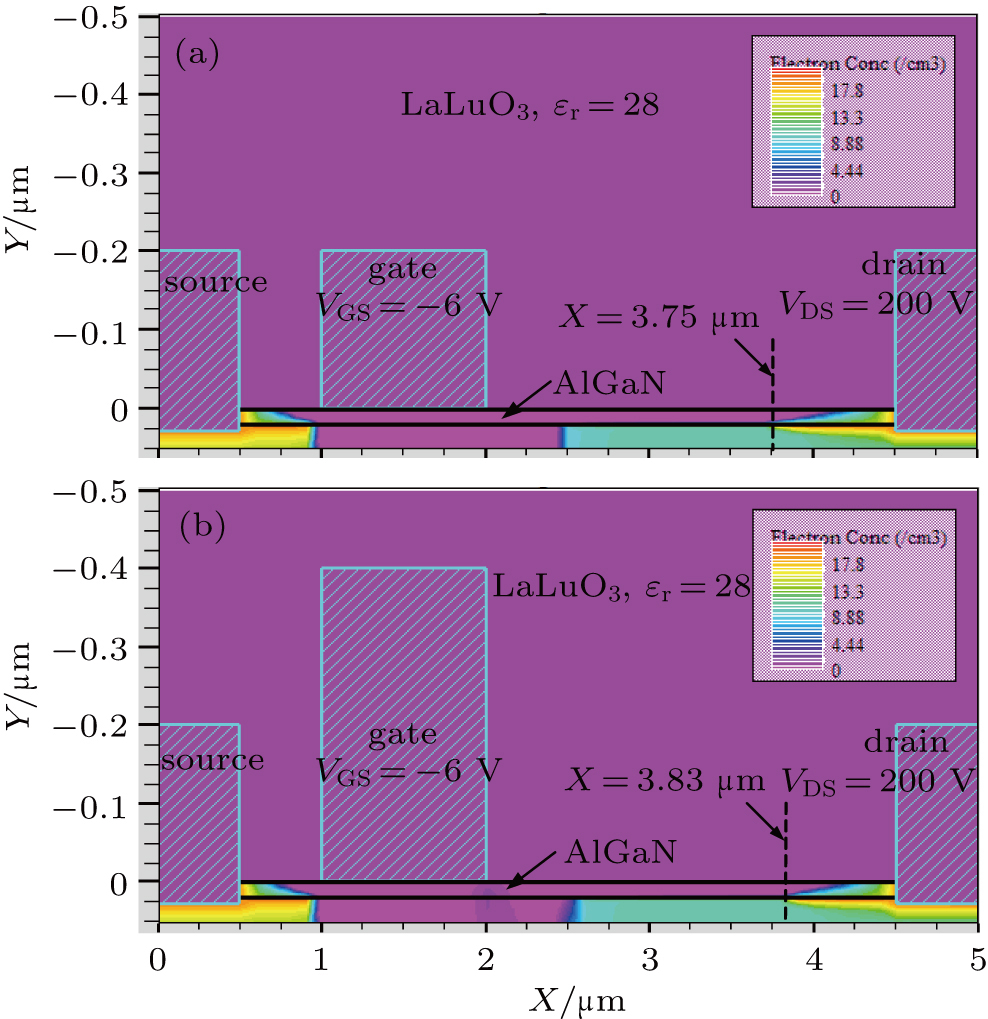 |