A novel enhancement mode AlGaN/GaN high electron mobility transistor with split floating gates
(color online) (a) The 















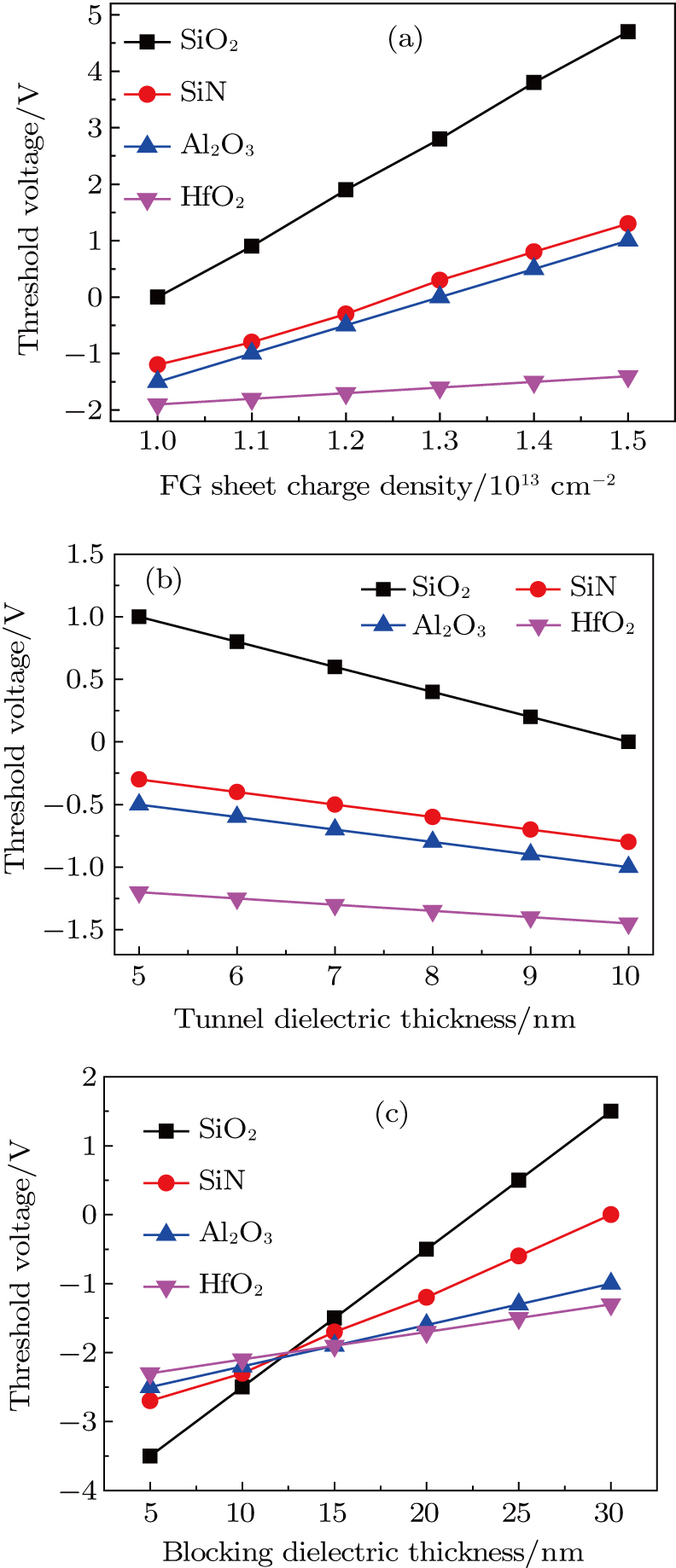
A novel enhancement mode AlGaN/GaN high electron mobility transistor with split floating gates |
|
(color online) (a) The |
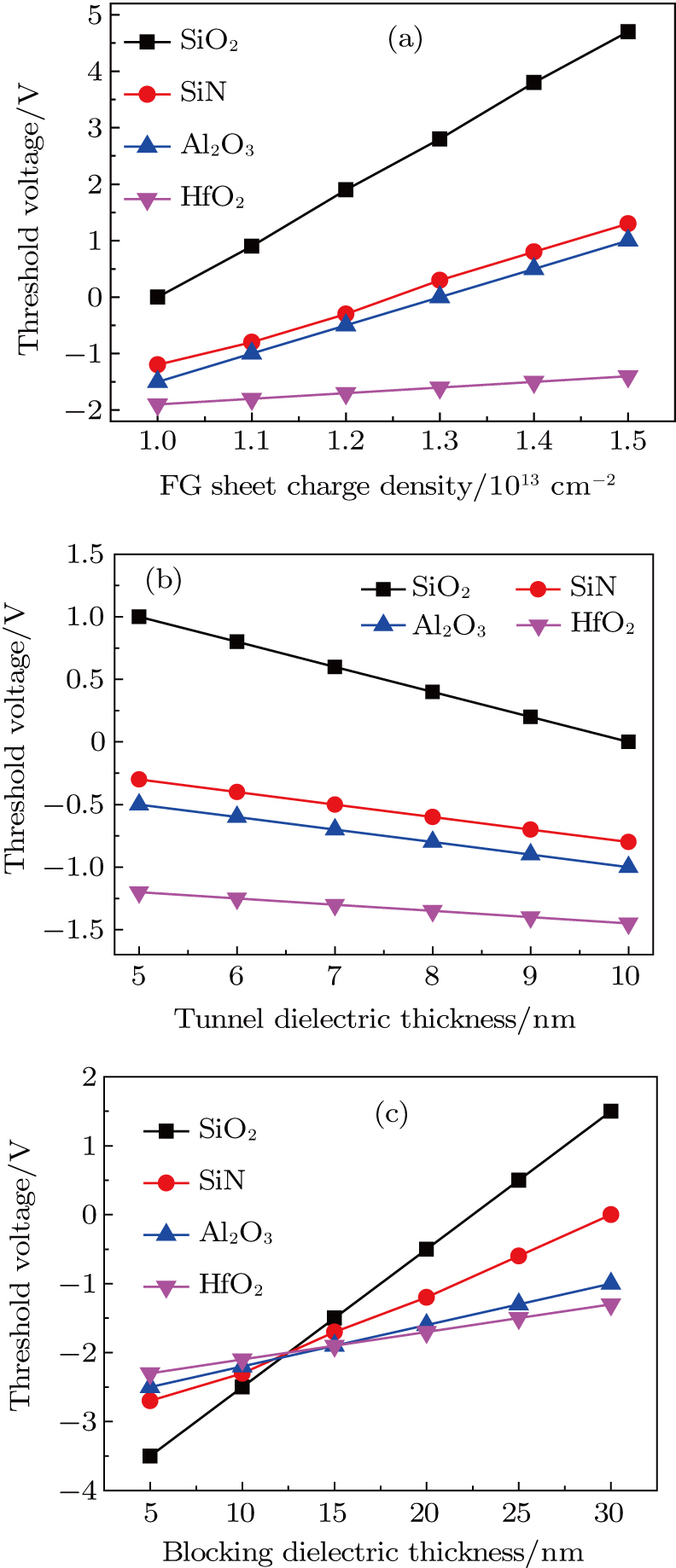 |