Fluid simulation of the pulsed bias effect on inductively coupled nitrogen discharges for low-voltage plasma immersion ion implantation
(color online) N 
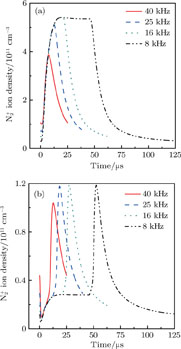
Fluid simulation of the pulsed bias effect on inductively coupled nitrogen discharges for low-voltage plasma immersion ion implantation |
|
(color online) N |
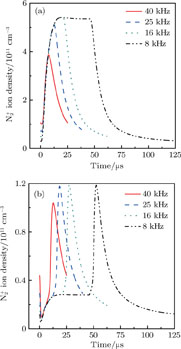 |