Study on influences of TiN capping layer on time-dependent dielectric breakdown characteristic of ultra-thin EOT high-
TDDB results for 1.4-nm and 2.4-nm TiN NMOSFET devices.
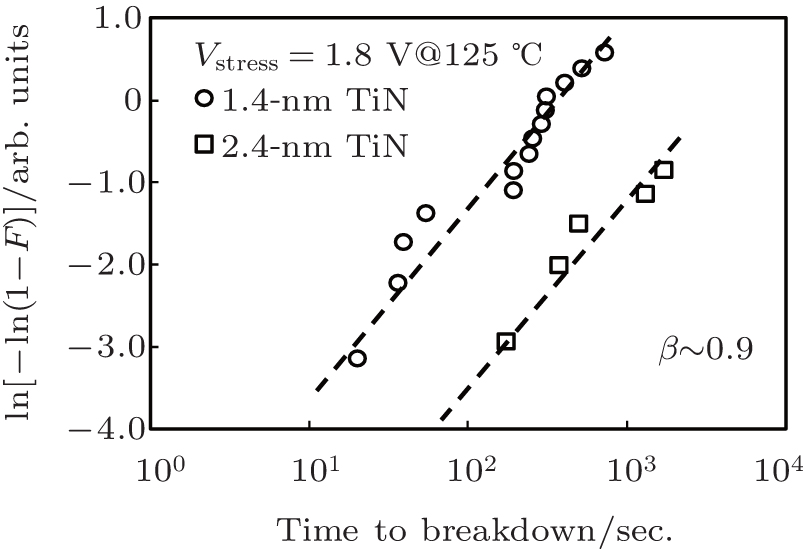
Study on influences of TiN capping layer on time-dependent dielectric breakdown characteristic of ultra-thin EOT high- |
TDDB results for 1.4-nm and 2.4-nm TiN NMOSFET devices. |
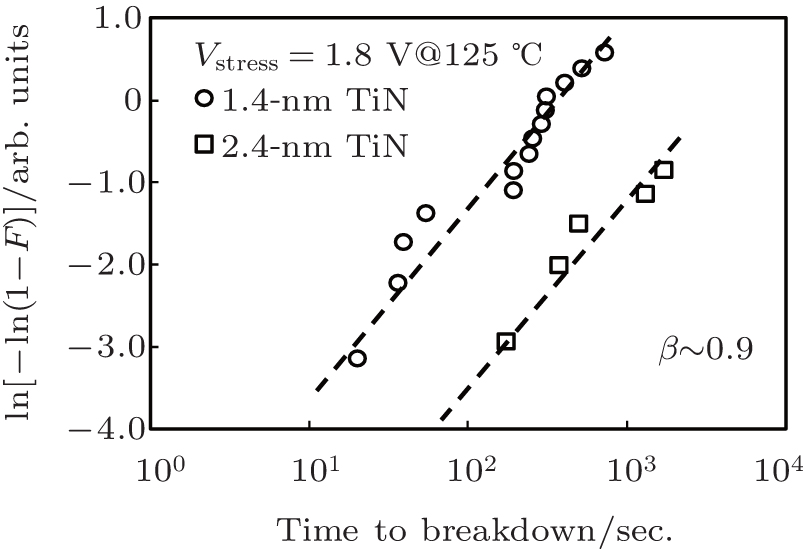 |