Breakdown mechanisms in AlGaN/GaN high electron mobility transistors with different GaN channel thickness values
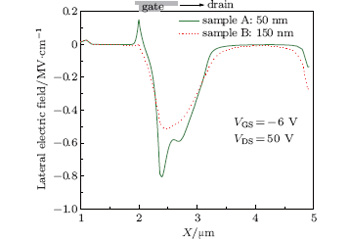
Breakdown mechanisms in AlGaN/GaN high electron mobility transistors with different GaN channel thickness values |
| Comparison of lateral field distribution along the channel/ buffer interface for HEMTs with different channel thickness values (50 nm and 150 nm), calculated at V DS = 50 V in off state ( V GS = −6 V), between samples A and B. |
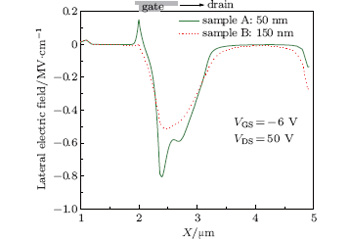 |