Influence of ultra-thin TiN thickness (1.4 nm and 2.4 nm) on positive bias temperature instability (PBTI) of high-
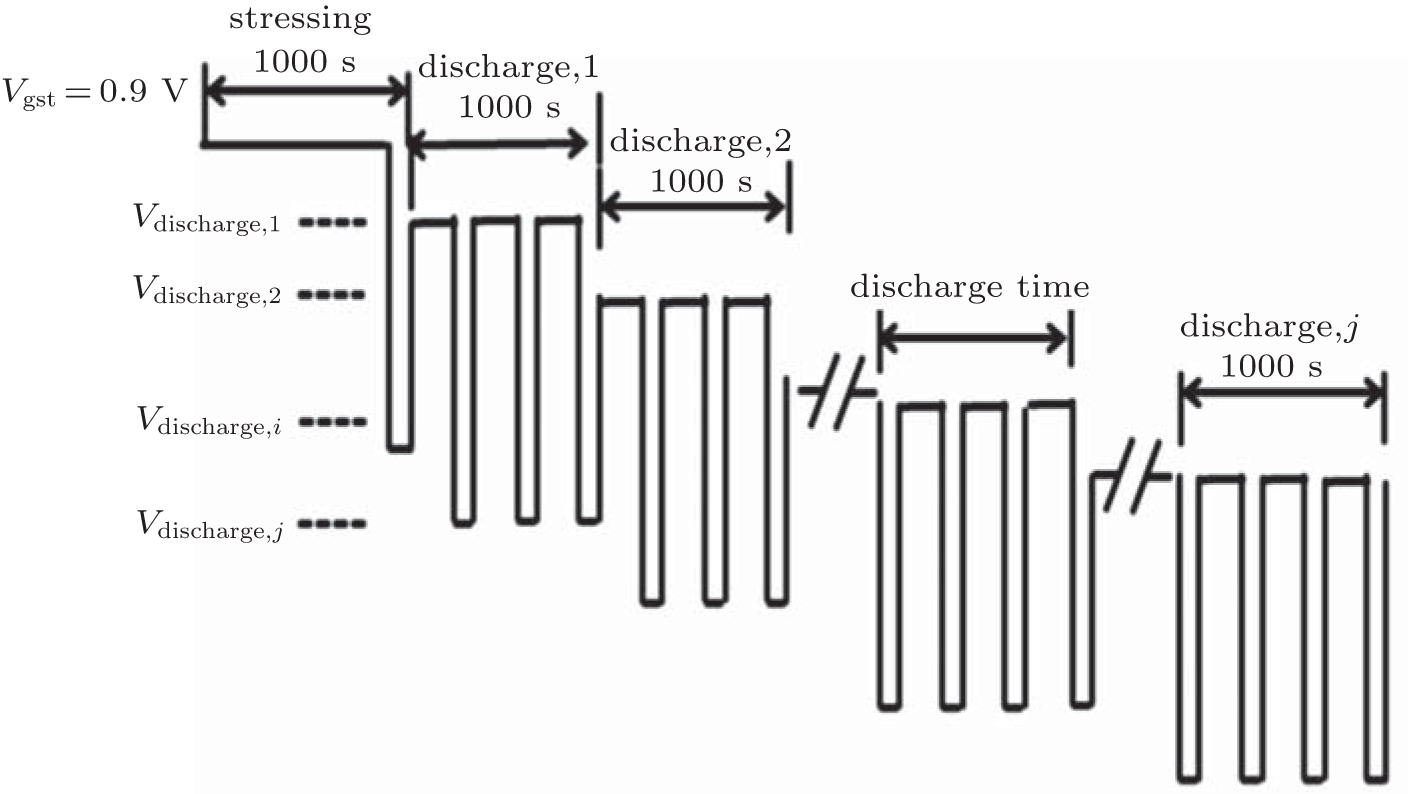
Influence of ultra-thin TiN thickness (1.4 nm and 2.4 nm) on positive bias temperature instability (PBTI) of high- |
| Vg waveform. After stress, discharging occurs at V discharge,1 for 1000 s. The gate bias is then changed to V discharge,2 for the next discharging phase and the same procedure is applied. |
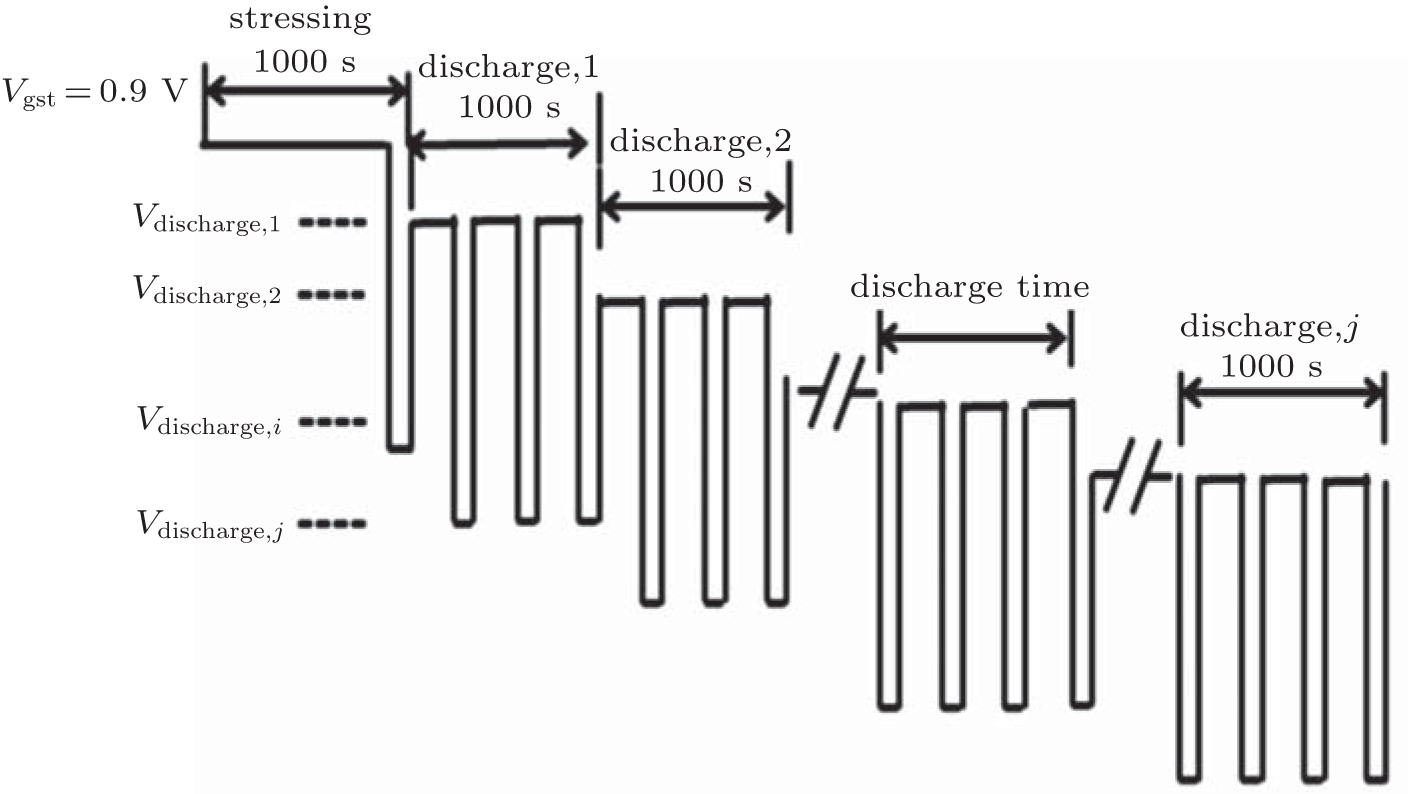 |