Influence of ultra-thin TiN thickness (1.4 nm and 2.4 nm) on positive bias temperature instability (PBTI) of high-
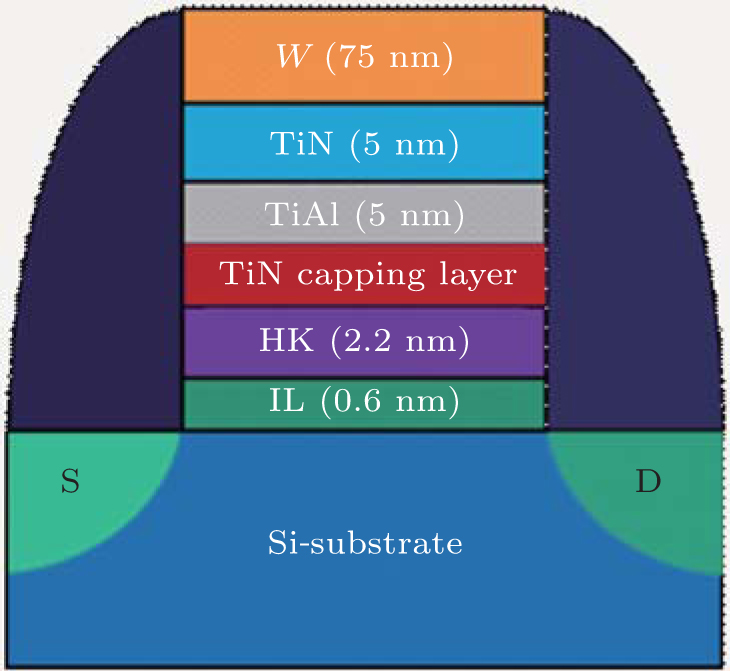
Influence of ultra-thin TiN thickness (1.4 nm and 2.4 nm) on positive bias temperature instability (PBTI) of high- |
| Structure of the nMOSFET tested in this work, the red layer is TiN capping layer. |
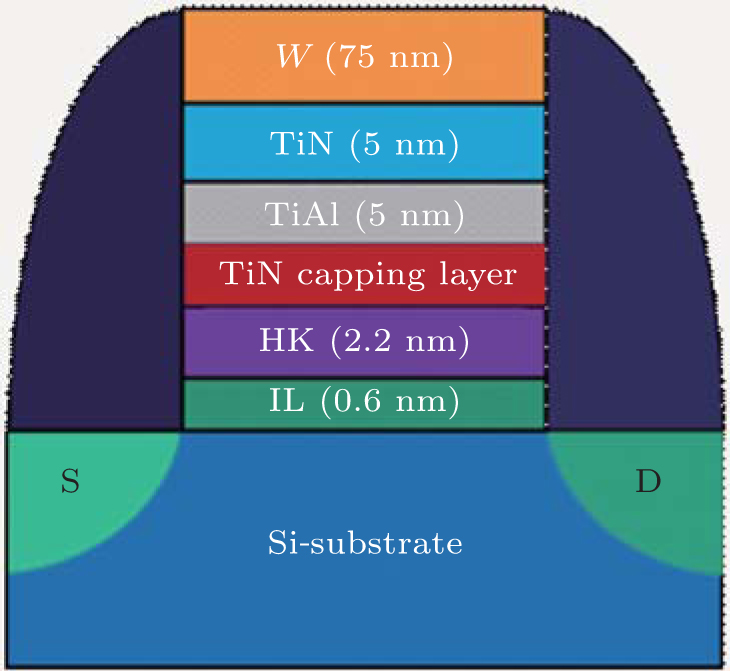 |